NANOFABRICATION
Responsable: Eloise DEVAUX
E-mail: devaux@unistra.fr
Tel:+33 (0)368 855 120
FIB :
Le système est un « cross-beam » Auriga de chez Zeiss .
Il possède à la fois un FIB (faisceau d’ions focalisé, source
d’ions Ga, tension 30kV) et un SEM (microscope électronique, source FEG, tension max 30kV). Il est équipé de GIS pour le dépôt assisté par faisceau d’ions (dépôts Pt,Au,W,SiOx) et pour la gravure assistée (XeF2, eau), d’un détecteur EDX et d’un détecteur d’électrons rétrodiffusés pour l’analyse, d’un système de compensation de charge pour les matériaux non-conducteurs et d’un « Fast Beam Blanker » pour la lithographie électronique .
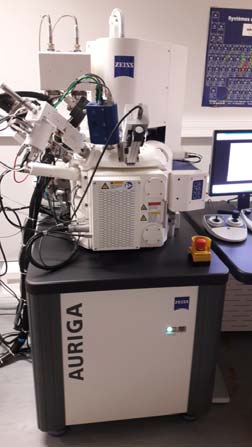
Aligneur de masques :
Le système est un aligneur de masques MJB3 de chez Süss Gmbh équipé d’une source UV400 Optics à 3 pics : 365nm, 405nm et 435nm.
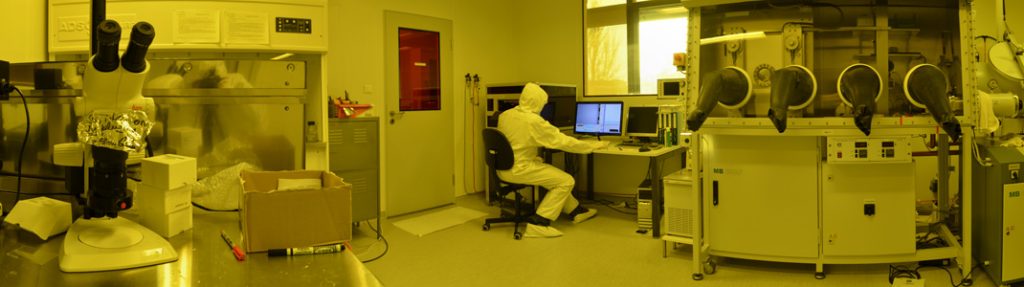
MEB : FEI QUANTA FEG 250

Le système est un QuantaFEG250 de chez ThermoFischerScientific
(anciennement FEI). Il possède une source FEG (tension max 30kV), un
détecteur STEM pour travailler en transmission, un détecteur EDX et un
détecteur d’électrons rétrodiffusés pour l’analyse. Il permet également
de travailler en mode low Vac avec une pression allant jusqu’à 130 Pa
dans la chambre ou en mode ESEM pour des pressions supérieures, avec la
possibilité d’utiliser une platine refroidie par effet Peltier pour les
échantillons hydratés.
